
Mi az a BGA Assembly?
A BGA összeszerelés a Ball Grid Array (BGA) NYÁK-ra történő felszerelésének folyamatát jelenti, reflow forrasztási technikával. A BGA egy felületre szerelt alkatrész, amely egy sor forrasztógolyót használ az elektromos összekapcsoláshoz. Ahogy az áramköri kártya áthalad egy forrasztó-visszafolyó kemencén, ezek a forrasztógolyók megolvadnak, és elektromos kapcsolatokat hoznak létre.
A BGA definíciója
BGA:Ball Grid Array
A BGA osztályozása
PBGA:műanyagBGA műanyag tokozású BGA
CBGA:BGA kerámia BGA csomagoláshoz
CCGA:Kerámia oszlop BGA kerámia oszlop
BGA formába csomagolva
TBGA:szalag BGA golyós rácsoszloppal
A BGA összeszerelés lépései
A BGA összeszerelési folyamata általában a következő lépésekből áll:
PCB előkészítés: A PCB-t úgy készítik elő, hogy forrasztópasztát visznek fel azokra az alátétekre, ahová a BGA-t rögzíteni fogják. A forrasztópaszta forrasztóötvözet részecskék és folyasztószer keveréke, amely segíti a forrasztási folyamatot.
A BGA-k elhelyezése: A BGA-kat, amelyek az integrált áramköri chipből állnak, alul forrasztógolyókkal, az előkészített NYÁK-ra helyezik. Ez általában automatizált pick-and-place gépekkel vagy egyéb összeszerelő berendezésekkel történik.
Reflow forrasztás: Az összeszerelt NYÁK-t az elhelyezett BGA-kkal ezután átengedik egy visszafolyó kemencén. A visszafolyó kemence felmelegíti a PCB-t egy meghatározott hőmérsékletre, amely megolvasztja a forrasztópasztát, ezáltal a BGA-k forrasztógolyói újrafolynak, és elektromos kapcsolatokat hoznak létre a PCB-betétekkel.
Hűtés és ellenőrzés: A forrasztási folyamat után a PCB-t lehűtik, hogy megszilárduljanak a forrasztási kötések. Ezt követően megvizsgálják, hogy nincs-e benne hiba, például helytelenség, rövidzárlat vagy nyitott csatlakozások. Erre a célra automatizált optikai vizsgálat (AOI) vagy röntgenvizsgálat használható.
Másodlagos folyamatok: A konkrét követelményektől függően további eljárások, például tisztítás, tesztelés és megfelelő bevonat is végrehajthatók a BGA összeszerelése után a késztermék megbízhatóságának és minőségének biztosítása érdekében.
A BGA Assembly előnyei

BGA Ball Grid Array

EBGA 680L
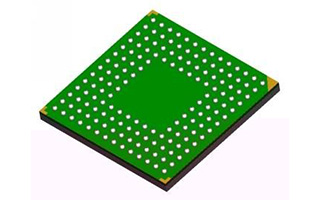
LBGA 160L

PBGA 217L műanyag golyós rács tömb

SBGA 192L

TSBGA 680L

CLCC

CNR
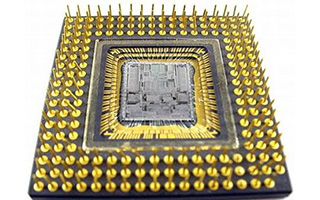
CPGA kerámia tűrácstömb

DIP Dual Inline csomag

DIP-fül

FBGA
1. Kis lábnyom
A BGA csomagolás a chipből, az összekötő elemekből, egy vékony hordozóból és egy kapszulázó burkolatból áll. Kevés a kitett alkatrész, és a csomagban minimális számú tű található. A NYÁK-on lévő chip teljes magassága akár 1,2 milliméter is lehet.
2. Robusztusság
A BGA csomagolás rendkívül robusztus. A 20 miles osztású QFP-vel ellentétben a BGA-ban nincsenek olyan tűk, amelyek elhajolhatnak vagy eltörhetnek. Általában a BGA eltávolításához magas hőmérsékleten egy BGA-feldolgozó állomást kell használni.
3. Alacsonyabb parazita induktivitás és kapacitás
A rövid tűkkel és az alacsony összeszerelési magassággal a BGA csomagolás alacsony parazita induktivitást és kapacitást mutat, ami kiváló elektromos teljesítményt eredményez.
4. Megnövelt tárhely
Más csomagolási típusokhoz képest a BGA-csomagolás térfogatának csak egyharmada és körülbelül 1,2-szerese a chipfelületnek. A BGA-csomagolást használó memória- és működési termékek több mint 2,1-szeres tárolókapacitás- és működési sebességnövekedést érhetnek el.
5. Nagy stabilitás
A BGA-csomagolásban lévő chip közepétől a tűk közvetlen meghosszabbításának köszönhetően a különböző jelek átviteli útvonalai hatékonyan lerövidülnek, csökkentve a jelgyengülést, és javítva a válaszsebességet és az interferencia-elhárítási képességeket. Ez növeli a termék stabilitását.
6. Jó hőelvezetés
A BGA kiváló hőelvezetési teljesítményt nyújt, a forgács hőmérséklete működés közben megközelíti a környezeti hőmérsékletet.
7. Kényelmes átdolgozáshoz
A BGA csomagolás tűi szépen el vannak rendezve az alján, így könnyen megtalálhatja a sérült területeket az eltávolításhoz. Ez megkönnyíti a BGA chipek átdolgozását.
8. A huzalozási káosz elkerülése
A BGA csomagolás lehetővé teszi számos táp- és földelő érintkező elhelyezését a közepén, az I/O érintkezők pedig a periférián. Az előútválasztás elvégezhető a BGA hordozón, elkerülve az I/O érintkezők kaotikus vezetékezését.
RichPCBA BGA összeszerelési képességek
A RICHPCBA világszerte elismert PCB-gyártás és PCB-összeállítás gyártója. A BGA összeszerelési szolgáltatás az általunk kínált számos szolgáltatástípus egyike. A PCBWay kiváló minőségű és költséghatékony BGA-összeállítást tud biztosítani a PCB-k számára. A BGA-összeállítás minimális osztásköze 0,25 mm 0,3 mm.
A RICHPCBA NYÁK-szolgáltatóként 20 éves PCB-gyártási, -gyártási és -összeszerelési tapasztalattal rendelkezik, gazdag háttérrel rendelkezik. Ha van igény BGA összeszerelésre, forduljon hozzánk bizalommal!

