PCB Surface Finish
| Uewerfläch Finish | Typesch Wäert | Fournisseur |
| Fräiwëllegen Pompjeeën | 0,3 ~ 0,55 um, 0,25 ~ 0,35 um | Enthone |
| Shikoku chemesch | ||
| ACCUEILER | Au: 0,03~0,12um, Ni: 2,5~5um | ATO Tech/Chuang Zhi |
| Selektiv ENIG | Au: 0,03~0,12um, Ni: 2,5~5um | ATO Tech/Chuang Zhi |
| PRINCIPPEL | Au: 0.05~0.125um, Pd: 0.05~0.3um, | Chuang Zhi |
| An: 3-10 um | ||
| Hard Gold | Au: 0,127~1,5um, Ni: min 2,5um | Bezueler/EEJA |
| Soft Gold | Au: 0,127~0,5um, Ni: min 2,5um | EJA |
| Immersion Tin | Min: 1 um | Enthone / ATO Tech |
| Immersioun Sëlwer | 0,127 ~ 0,45 um | Macdermid |
| Bleifräi HASL | 1-25 um | Nihon Superior |
Wéinst der Tatsaach, datt Kupfer a Form vun Oxiden an der Loft existéiert, beaflosst et eescht d'Lötbarkeet an d'elektresch Leeschtung vu PCBs. Dofir ass et néideg fir Uewerflächefinanzéierung vu PCBs auszeféieren. Wann d'Uewerfläch vu PCBs net fäerdeg ass, ass et einfach virtuell Lötproblemer ze verursaachen, an a schwéiere Fäll kënnen d'Lötpads a Komponenten net solderéiert ginn. PCB Surface Finish bezitt sech op de Prozess fir kënschtlech eng Uewerflächeschicht op engem PCB ze bilden. Den Zweck vum PCB-Finish ass ze garantéieren datt de PCB gutt Lötbarkeet oder elektresch Leeschtung huet. Et gi vill Aarte vu Surface Finish fir PCBs.
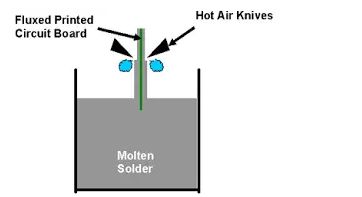
Hot Air Solder Leveling (HASL)
Et ass e Prozess fir geschmollte Bläi-Lout op der Uewerfläch vun engem PCB opzemaachen, et mat gehëtzter kompriméierter Loft ze flaach (blosen) an eng Schicht Beschichtung ze bilden déi souwuel resistent géint Kupferoxidatioun ass a gutt Lötbarkeet ubitt. Wärend dësem Prozess ass et néideg déi folgend wichteg Parameteren ze beherrschen: soldering Temperatur, waarm Loft Messer Temperatur, waarm Loft Messer Drock, immersion Zäit, Levée Vitesse, etc.
Virdeel vun HASL
1. Méi laang Stockage Zäit.
2. Gutt Padbefeuchtung a Kupferdeckung.
3. Breet benotzt Bleifräi (RoHS-kompatibel) Typ.
4. Mature Technologie, niddreg Käschten.
5. Ganz gëeegent fir visuell Inspektioun an elektresch Testen.
Schwäch vun HASL
1. Net gëeegent fir Drot Bindung.
2. Wéinst dem natierlechen Meniskus vum geschmoltenem Löt ass d'Flaachheet schlecht.
3. Net applicabel fir capacitive Touch Schalter.
4. Fir besonnesch dënn Paneele kann HASL net gëeegent sinn. Déi héich Temperatur vum Bad kann de Circuit Board verursaachen.
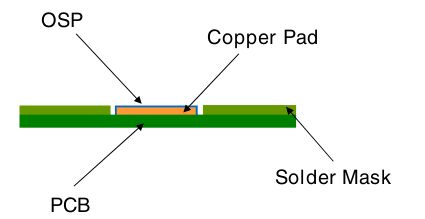
2. Fräiwëllegen Pompjeeën
OSP ass d'Ofkierzung fir Organic Solderability Preservative, och bekannt als pro solder. Kuerz gesot, OSP ass dat fir op d'Uewerfläch vu Kupfer-Lodpads ze sprëtzen fir e Schutzfilm aus organesche Chemikalien ze bidden. Dëse Film muss Eegeschafte wéi Oxidatiounsbeständegkeet, thermesch Schockbeständegkeet a Feuchtigkeitbeständegkeet hunn, fir d'Kupferoberfläche vu Rust (Oxidatioun oder Vulkaniséierung, etc.) an normalen Ëmfeld ze schützen. Wéi och ëmmer, an der spéider Héichtemperatur-Lötung, muss dëse Schutzfilm liicht duerch de Flux séier ofgeschaaft ginn, sou datt déi exponéiert propper Kupferfläche direkt mat der geschmoltenem Löt verbannen kann fir e staarkt Lötverbindung a ganz kuerzer Zäit ze bilden. An anere Wierder, d'Roll vum OSP ass als Barrière tëscht Kupfer a Loft ze handelen.
Virdeel vun OSP
1. Einfach a bezuelbar; D'Uewerfläch ass nëmme Spraybeschichtung.
2. D'Uewerfläch vum Solderpad ass ganz glat, mat enger Flaachheet vergläichbar mat ENIG.
3. Bleiffräi (konform mat RoHS Normen) an ëmweltfrëndlech.
4. Reworkable.
Schwäch vun OSP
1. Schlecht befeuchtbarkeet.
2. Déi kloer an dënn Natur vum Film bedeit datt et schwéier ass Qualitéit duerch visuell Inspektioun ze moossen an online Tester ze maachen.
3. Kuerz Liewensdauer, héich Ufuerderunge fir Lagerung an Handhabung.
4. Schlecht Schutz fir plated duerch Lächer.
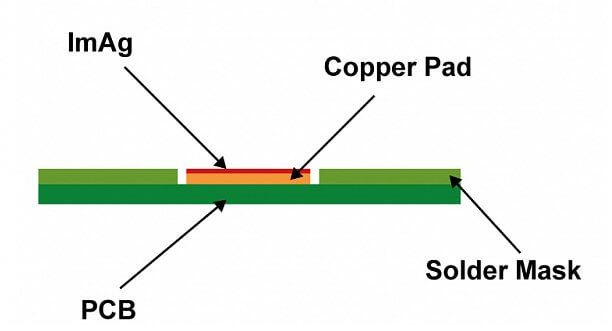
Immersioun Sëlwer
Sëlwer huet stabil chemesch Eegeschaften. De PCB, deen duerch Sëlwer-Immersiounstechnologie veraarbecht gëtt, kann nach ëmmer gutt elektresch Leeschtung ubidden, och wann se op héijer Temperatur, fiichten a verschmotzten Ëmfeld ausgesat sinn, souwéi eng gutt Solderbarkeet behalen, och wann et säi Glanz verléieren kann. Immersion Sëlwer ass eng Verdrängungsreaktioun wou eng Schicht vu purem Sëlwer direkt op Kupfer deposéiert gëtt. Heiansdo gëtt Tauchsëlwer mat OSP-Beschichtungen kombinéiert fir datt Sëlwer net mat Sulfiden an der Ëmwelt reagéiert.
Virdeel vun Immersion Silver
1. Héich solderability.
2. Good Uewerfläch flatness.
3. Niddereg Käschten a Bleifräi (konform mat RoHS Standards).
4. Uwendbar fir Al Drot Bindung.
Schwäch vun Immersion Sëlwer
1. Héich Stockage Ufuerderunge an einfach verschmotzt gin.
2. Kuerz Montage Fënster Zäit nodeems se aus der Verpakung huelen.
3. Schwéier elektresch Tester ze maachen.
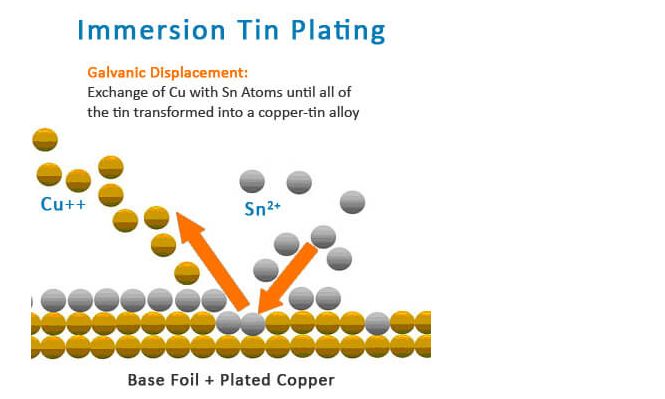
Immersion Tin
Zënter all solder ass Zinn baséiert, kann d'Zinn Schicht all Zort vun solder Match. Nodeems d'Bio-Additive fir d'Zinn-Immersiounsléisung bäigefüügt ginn, stellt d'Zinnschichtstruktur eng granulär Struktur vir, déi d'Problemer iwwerwannen, déi duerch Zinn-Whiskers an Zinnmigratioun verursaacht ginn, wärend och eng gutt thermesch Stabilitéit a Solderbarkeet huet.
Den Immersion Tin-Prozess kann flaach Kupfer-Zinn intermetallesch Verbindunge bilden fir Tauchzinn eng gutt Lötbarkeet ze maachen ouni Flaachheet oder intermetallesch Verbindungsdiffusiounsprobleemer.
Virdeel vun Immersion Tin
1. Uwendbar fir horizontal Produktioun Linnen.
2. Uwendbar fir fein Drotveraarbechtung a Bleifräi Löt, besonnesch applicabel fir Crimpprozess.
3. D'Flaachheet ass ganz gutt, applicabel fir SMT.
Schwäch vun Immersion Tin
1. Héich Stockage Noutwendegkeete, kann Fangerofdréck Faarf änneren.
2. Zinn Whiskers kënne Kuerzschluss a Solderverbindungsproblemer verursaachen, an doduerch d'Haltdauer verkierzen.
3. Schwéier elektresch Tester ze maachen.
4. De Prozess ëmfaasst carcinogens.
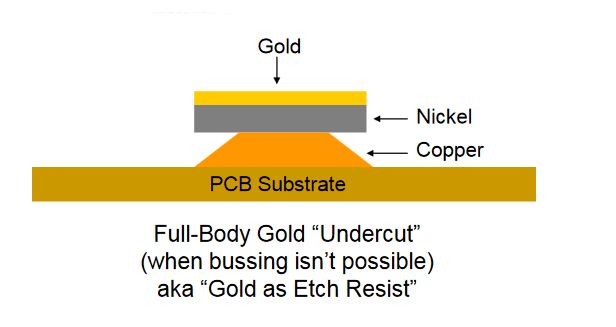
ACCUEILER
ENIG (Electroless Nickel Immersion Gold) ass eng wäit benotzt Uewerflächbeschichtung besteet aus 2 Metallschichten, wou Nickel direkt op Kupfer deposéiert gëtt an dann Goldatome op Kupfer duerch Verdrängungsreaktiounen placéiert ginn. D'Dicke vun der banneschten Néckelschicht ass allgemeng 3-6um, an d'Depositiounsdicke vun der Goldbaussenschicht ass allgemeng 0,05-0,1um. Den Nickel bildt eng Barriärschicht tëscht Löt a Kupfer. D'Funktioun vum Gold ass d'Nickeloxidatioun während der Lagerung ze vermeiden, an doduerch d'Haltdauer ze verlängeren, awer den Tauchegoldprozess kann och exzellent Uewerflächeflächheet produzéieren.
D'Veraarbechtungsfloss vun ENIG ass: Botzen--> Ätzen--> Katalysator--> chemesch Néckelbeschichtung--> Goldablagerung--> Reinigungsreschter
Virdeel vun ENIG
1. Gëeegent fir Bläi gratis (RoHS konform) soldering.
2. Excellent Uewerfläch glatt.
3. Laang Haltbarkeet an haltbar Uewerfläch.
4. Gëeegent fir Al Drot Bindung.
Schwäch vun ENIG
1. Deier wéinst Gold benotzt.
2. Komplexe Prozess, schwéier ze kontrolléieren.
3. Einfach schwaarz Pad Phänomen ze generéieren.
Elektrolytesch Néckel / Gold (hard Gold / Soft Gold)
Elektrolytesch Néckelgold gëtt an "hard Gold" a "mëll Gold" opgedeelt. Hard Gold huet eng geréng Rengheet a gëtt allgemeng a Goldfinger (PCB Randverbindungen), PCB Kontakter oder aner verschleißbeständeg Beräicher benotzt. D'Dicke vum Gold kann jee no Ufuerderunge variéieren. Soft Gold huet eng méi héich Rengheet a gëtt allgemeng an Drotverbindung benotzt.
Virdeel vun Electrolytic Néckel / Gold
1. Méi laang Haltbarkeet.
2. Geeignet fir Kontaktschalter an Drotverbindung.
3. Hard Gold ass gëeegent fir elektresch Testen.
4. Bleiffräi (RoHS-kompatibel)
Schwäch vun elektrolytesche Néckel / Gold
1. Déi deierste Uewerfläch.
2. Electroplating Gold Fangeren erfuerderen zousätzlech leitend Drot.
3. Huet Gold huet schlecht solderability. Wéinst der Golddicke si méi déck Schichten méi schwéier ze solderen.
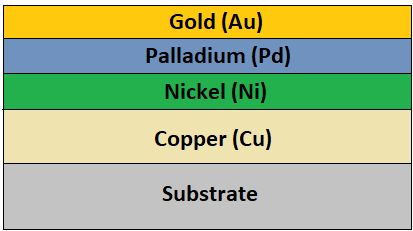
PRINCIPPEL
Electroless Nickel Electroless Palladium Immersion Gold oder ENEPIG gëtt ëmmer méi fir PCB Surface Finish benotzt. Am Verglach mam ENIG füügt ENEPIG eng extra Schicht vu Palladium tëscht Nickel a Gold fir d'Nickelschicht weider vu Korrosioun ze schützen an ze vermeiden datt schwaarz Pads generéiert ginn, déi liicht am ENIG Surface Finish Prozess geformt ginn. D'Depositiounsdicke vum Néckel ass ongeféier 3-6um, d'Dicke vum Palladium ass ongeféier 0.1-0.5um an d'Dicke vum Gold ass 0.02-0.1um. Och wann d'Dicke vum Gold méi kleng ass wéi ENIG, ass den ENEPIG méi deier. Wéi och ëmmer, de rezente Réckgang vun de Palladiumskäschte huet dem ENEPIG säi Präis méi bezuelbar gemaach.
Virdeel vun ENEPIG
1. Huet all Virdeeler vun ENIG, kee schwaarz Pad Phänomen.
2. Méi gëeegent fir Drot Bindung wéi ENIG.
3. Kee Risiko vu Korrosioun.
4. Laang Späicherzäit, Bleifräi (RoHS-kompatibel)
Schwäch vun ENEPIG
1. Komplexe Prozess, schwéier ze kontrolléieren.
2. Héich Käschten.
3. Et ass eng relativ nei Method an nach net reift.

