
การประกอบ BGA คืออะไร?
การประกอบ BGA หมายถึงกระบวนการติดตั้ง Ball Grid Array (BGA) ลงบน PCB โดยใช้เทคนิคการบัดกรีแบบรีโฟลว์ BGA เป็นส่วนประกอบที่ติดตั้งบนพื้นผิวซึ่งใช้อาร์เรย์ของลูกบอลบัดกรีสำหรับการเชื่อมต่อโครงข่ายไฟฟ้า เมื่อแผงวงจรผ่านเตาอบแบบบัดกรี ลูกบัดกรีเหล่านี้จะละลายและกลายเป็นจุดเชื่อมต่อทางไฟฟ้า
คำจำกัดความของ BGA
บีจีเอ:อาร์เรย์กริดบอล
การจำแนกประเภทของ BGA
พีบีจีเอ:พลาสติกBGA พลาสติกห่อหุ้ม BGA
CBGA:BGA สำหรับบรรจุภัณฑ์ BGA เซรามิก
ซีซีจีเอ:เสาเซรามิค BGA เสาเซรามิค
BGA บรรจุในรูปทรง
TBGA:เทป BGA พร้อมคอลัมน์ตารางบอล
ขั้นตอนการประกอบ BGA
โดยทั่วไปกระบวนการประกอบ BGA จะเกี่ยวข้องกับขั้นตอนต่อไปนี้:
การเตรียม PCB: PCB ถูกเตรียมโดยการใช้สารบัดกรีกับแผ่นอิเล็กโทรดที่จะติดตั้ง BGA สารบัดกรีเป็นส่วนผสมของอนุภาคโลหะผสมบัดกรีและฟลักซ์ ซึ่งช่วยในกระบวนการบัดกรี
การวางตำแหน่ง BGA: BGA ซึ่งประกอบด้วยชิปวงจรรวมที่มีลูกบัดกรีที่ด้านล่าง จะถูกวางลงบน PCB ที่เตรียมไว้ โดยทั่วไปจะทำโดยใช้เครื่องหยิบและวางแบบอัตโนมัติหรืออุปกรณ์ประกอบอื่นๆ
การบัดกรีแบบ Reflow: PCB ที่ประกอบแล้วพร้อมกับ BGA ที่วางอยู่จะถูกส่งผ่านเตาอบแบบรีโฟลว์ เตาอบ reflow จะทำความร้อน PCB จนถึงอุณหภูมิที่กำหนดซึ่งจะทำให้สารบัดกรีละลาย ส่งผลให้ลูกบอลบัดกรีของ BGA ไหลกลับและสร้างการเชื่อมต่อทางไฟฟ้ากับแผ่น PCB
การทำความเย็นและการตรวจสอบ: หลังจากกระบวนการบัดกรีใหม่ PCB จะถูกระบายความร้อนลงเพื่อทำให้ข้อต่อบัดกรีแข็งตัว จากนั้นจะมีการตรวจสอบข้อบกพร่องใดๆ เช่น การเยื้องศูนย์ การลัดวงจร หรือการเชื่อมต่อแบบเปิด อาจใช้การตรวจสอบด้วยแสงอัตโนมัติ (AOI) หรือการตรวจสอบด้วยรังสีเอกซ์เพื่อจุดประสงค์นี้
กระบวนการรอง: กระบวนการเพิ่มเติม เช่น การทำความสะอาด การทดสอบ และการเคลือบตามข้อกำหนดอาจดำเนินการได้หลังจากการประกอบ BGA ทั้งนี้ขึ้นอยู่กับข้อกำหนดเฉพาะ เพื่อให้มั่นใจในความน่าเชื่อถือและคุณภาพของผลิตภัณฑ์สำเร็จรูป
ข้อดีของการประกอบ BGA

อาร์เรย์กริดบอล BGA

อีบีจีเอ 680L
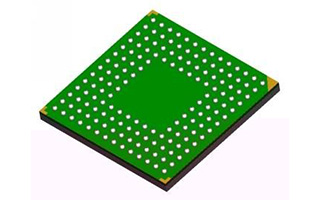
บีบีจีเอ 160 ลิตร

PBGA 217L ลูกกริดอาร์เรย์พลาสติก

เอสบีจีเอ 192L

ทีเอสบีจีเอ 680L

ซีแอลซีซี

ซีเอ็นอาร์
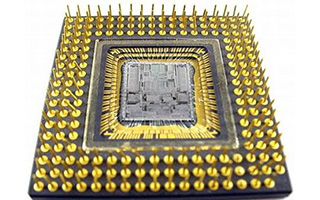
อาร์เรย์กริดพินเซรามิก CPGA

แพ็คเกจอินไลน์คู่กรมทรัพย์สินทางปัญญา

แท็บกรมทรัพย์สินทางปัญญา

เอฟบีจีเอ
1. รอยเท้าขนาดเล็ก
บรรจุภัณฑ์ BGA ประกอบด้วยชิป อุปกรณ์เชื่อมต่อระหว่างกัน วัสดุพิมพ์แบบบาง และฝาปิดแบบห่อหุ้ม มีส่วนประกอบที่ถูกเปิดเผยน้อยและแพ็คเกจมีจำนวนพินน้อยที่สุด ความสูงโดยรวมของชิปบน PCB สามารถต่ำได้ถึง 1.2 มิลลิเมตร
2. ความทนทาน
บรรจุภัณฑ์ BGA มีความทนทานสูง ต่างจาก QFP ที่มีระยะพิทช์ 20 มิลลิเมตร BGA ไม่มีพินที่สามารถงอหรือหักได้ โดยทั่วไป การกำจัด BGA ต้องใช้สถานีปรับปรุง BGA ที่อุณหภูมิสูง
3. ลดความเหนี่ยวนำและความจุของปรสิต
ด้วยพินที่สั้นและความสูงของการประกอบต่ำ บรรจุภัณฑ์ BGA จึงมีความเหนี่ยวนำและความจุของปรสิตต่ำ ส่งผลให้ประสิทธิภาพทางไฟฟ้าดีเยี่ยม
4. เพิ่มพื้นที่จัดเก็บ
เมื่อเทียบกับบรรจุภัณฑ์ประเภทอื่นๆ บรรจุภัณฑ์ BGA มีปริมาตรเพียง 1 ใน 3 และพื้นที่ชิปประมาณ 1.2 เท่า หน่วยความจำและผลิตภัณฑ์ด้านการปฏิบัติงานที่ใช้บรรจุภัณฑ์ BGA สามารถเพิ่มความจุในการจัดเก็บข้อมูลและความเร็วในการดำเนินการได้มากกว่า 2.1 เท่า
5. ความมั่นคงสูง
เนื่องจากการขยายพินโดยตรงจากศูนย์กลางของชิปในบรรจุภัณฑ์ BGA เส้นทางการส่งสัญญาณต่างๆ จึงสั้นลงอย่างมีประสิทธิภาพ ลดการลดทอนสัญญาณ และปรับปรุงความเร็วการตอบสนองและความสามารถในการป้องกันการรบกวน สิ่งนี้จะช่วยเพิ่มความเสถียรของผลิตภัณฑ์
6. ระบายความร้อนได้ดี
BGA มอบประสิทธิภาพการกระจายความร้อนที่ยอดเยี่ยม โดยอุณหภูมิของชิปจะเข้าใกล้อุณหภูมิแวดล้อมระหว่างการทำงาน
7. สะดวกสำหรับการทำงานซ้ำ
หมุดของบรรจุภัณฑ์ BGA ได้รับการจัดเรียงอย่างเรียบร้อยที่ด้านล่าง ทำให้ง่ายต่อการค้นหาบริเวณที่เสียหายเพื่อนำออก สิ่งนี้อำนวยความสะดวกในการทำงานซ้ำของชิป BGA
8. หลีกเลี่ยงความวุ่นวายในการเดินสายไฟ
บรรจุภัณฑ์ BGA ช่วยให้สามารถวางพินกำลังและกราวด์จำนวนมากไว้ตรงกลาง โดยมีพิน I/O อยู่ที่บริเวณรอบนอก การกำหนดเส้นทางล่วงหน้าสามารถทำได้บนซับสเตรต BGA เพื่อหลีกเลี่ยงการเดินสายที่วุ่นวายของพิน I/O
ความสามารถในการประกอบ RichPCBA BGA
RICHPCBA เป็นผู้ผลิต PCB และการประกอบ PCB ที่มีชื่อเสียงระดับโลก บริการประกอบ BGA เป็นหนึ่งในบริการหลายประเภทที่เรานำเสนอ PCBWay สามารถจัดหาชุดประกอบ BGA คุณภาพสูงและคุ้มค่าสำหรับ PCB ของคุณ ระยะห่างขั้นต่ำสำหรับการประกอบ BGA ที่เราสามารถรองรับได้คือ 0.25 มม. 0.3 มม.
ในฐานะผู้ให้บริการ PCB ที่มีประสบการณ์ 20 ปีในการผลิต การผลิต และการประกอบ PCB RICHPCBA มีพื้นฐานมายาวนาน หากมีความต้องการในการประกอบ BGA โปรดติดต่อเรา!

